メルプレートUBM 前処理プロセス

UBM形成技術
フリップチップ法では、半導体チップは実装基板へバンプを介して接合されます。チップ上のAl電極とはんだの界面には、相互拡散を抑制するためのバリア層としてUBMを形成します。UBMはUnder Bump MetalもしくはUnder Barrier Metalの略称で、バリア性およびはんだ接合時の表面保護の目的から、ニッケル/金やニッケル/パラジウム/金などの構成で形成されます。
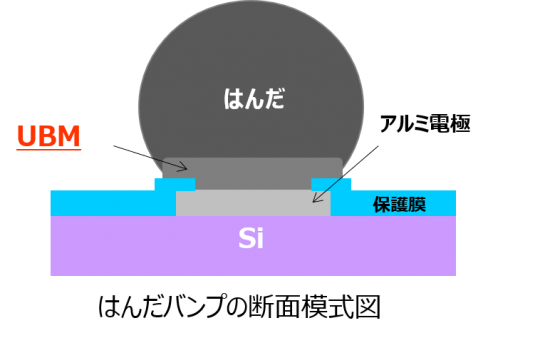
無電解めっきによるUBM形成
めっきによってUBMを形成する方法として、電解めっきと無電解めっきが考えられます。メルテックスが提供する「メルプレートUBMプロセス」は無電解めっきによってUBMを形成できるプロセスです。
無電解めっきは金属電極上に選択的にめっき被膜を形成できるため、バンプ形成において露光/現像工程が必要なく、レジストレスで被膜形成が可能です。また、UBMおよびはんだバンプの高さが安定する優位性も有しています。
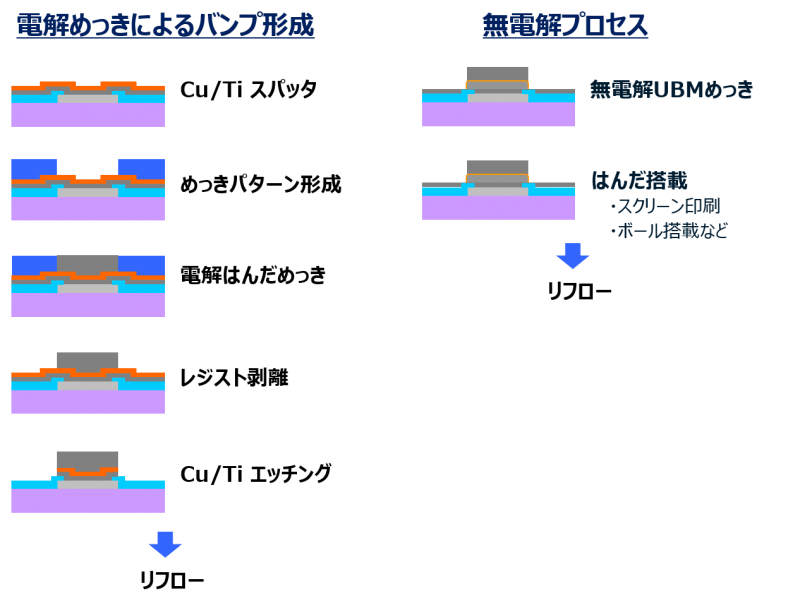
メルプレートUBMプロセスの優れた前処理
メルプレートUBMプロセスの前処理は、特許技術を含む各工程を最適化することにより、“様々なアルミ電極の種類に対応”し、“電極へのダメージを最小限にすることで平滑性に優れたUBMを形成する”ことが可能な処理プロセスです。
本前処理プロセスの後、無電解めっきにより、Ni/Pd、Ni/Pd/AuなどのUBMを形成します。
Al電極の種類に依存しない前処理(特許技術)
Al電極の材質としては、純Alの他、Al-Cu、Al-Si-Cu、Al-SiなどのAl合金が用いられます。Al合金の種類によっては、ジンケート処理が不均一となり、めっき外観不良の原因となる場合があります。
メルプレートUBMプロセスの前処理では、特許取得のエッチングおよびコンディショニング処理により、アルミニウム電極の種類によらない前処理を実現しました。これにより、その後のジンケート処理が均一となります。また、設計上発生する電極の電位差や配向性の違いによるめっき膜厚差やめっき未析出についても対応します。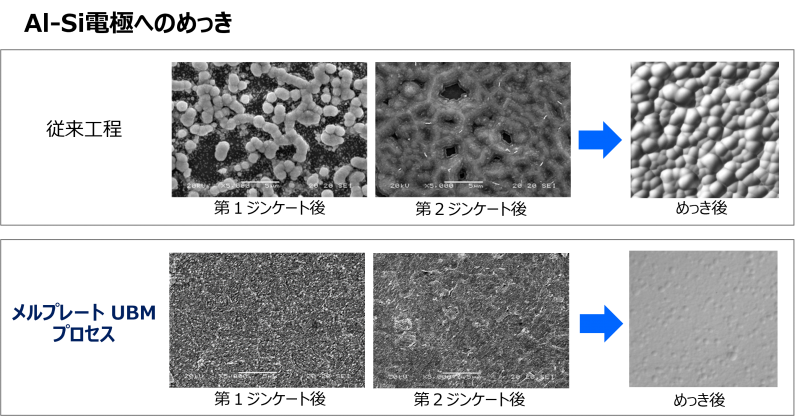
ニッケルスパイクを抑制するジンケート処理
アルミ電極へ無電解めっきを施すには、ジンケート処理と呼ばれる亜鉛置換処理を行います。通常、第1ジンケート処理と第2ジンケート処理には同じ薬品が用いられますが、メルプレートUBMプロセスでは第1と第2処理の目的を明確にし、それぞれの目的に合わせた薬品を準備しました。
第1ジンケートではアルミ電極の局部腐食を抑制するため、第2ジンケートではめっき被膜の高い密着性を実現するために最適化されています。これにより、めっき後のニッケルスパイクを最小限にし、めっき被膜の高い密着性を実現しました。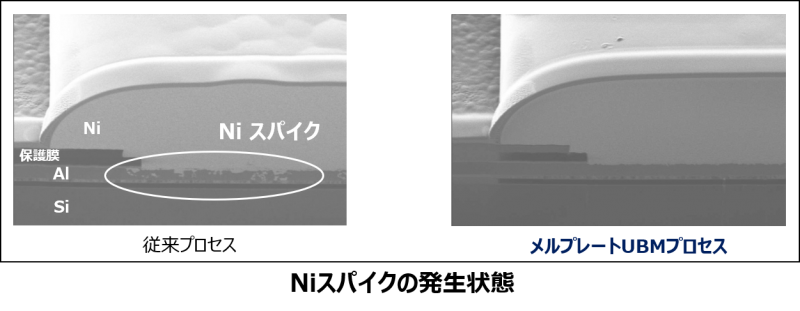
メルプレートUBMプロセスの特長
メルプレートUBMプロセスは、Al電極上に無電解ニッケル金、無電解ニッケルパラジウム金めっきの被膜を形成するためのプロセスです。メルプレートUBMプロセスの前処理プロセスは、以下の特長を持ちます。
- ・Al合金電極へのダメージが少ない
- ・Al合金種に依存しない
- ・電極電位による影響が少ない
これらの特長の結果として、アルミ/無電解ニッケル界面にニッケルスパイクがなく、表面平滑な無電解めっき被膜を密着よく形成することが可能です。
お問い合わせ
より詳しい特性データのご要望、用途・試作についてのご相談など、お気軽にお申しつけください。
まずはメールにてご返答させていただきます。

