なぜSiCパワーデバイスのめっきは剥がれるのか?
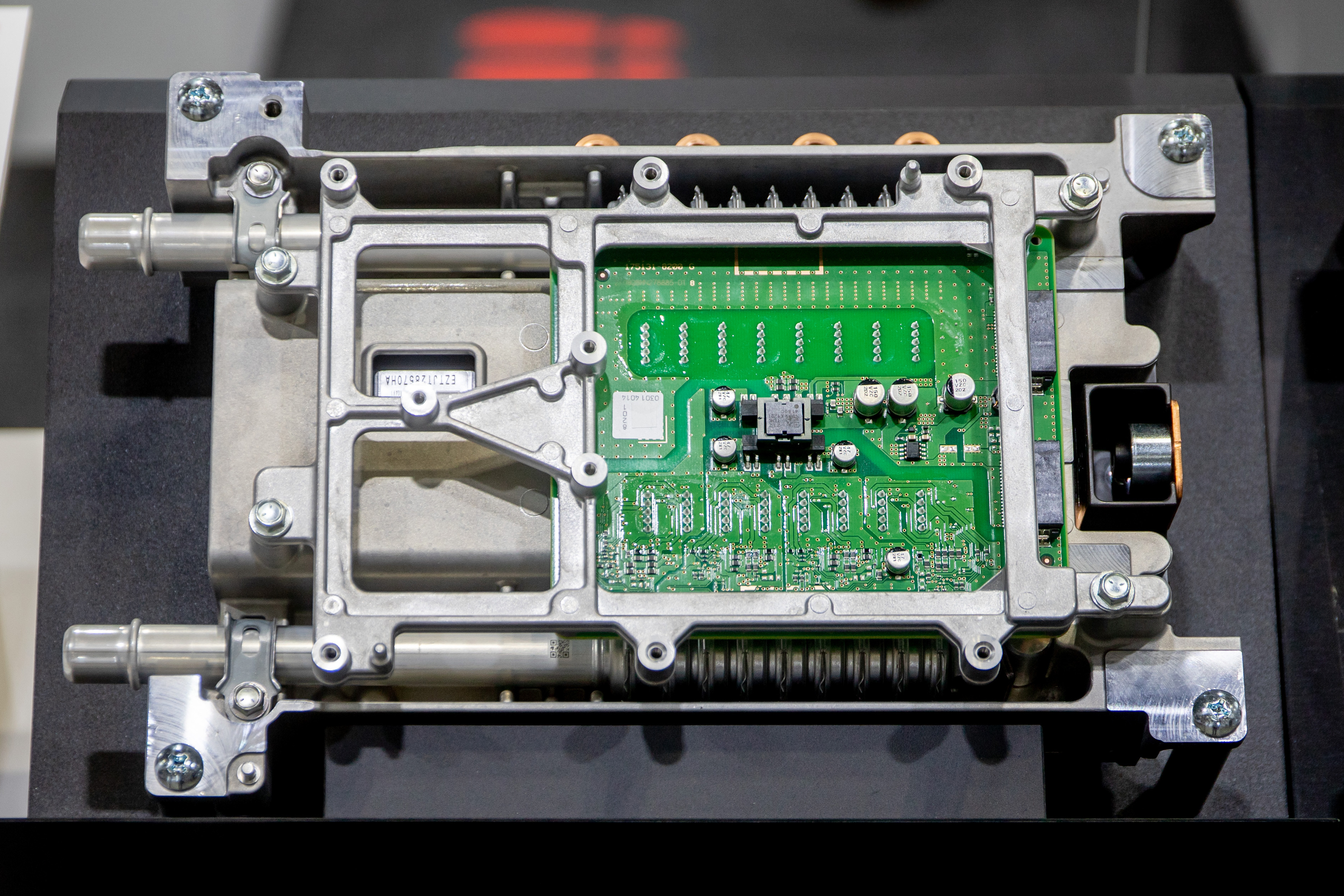
SiC(炭化ケイ素)を採用した次世代パワー半導体の開発において、電極部のめっき剥離はデバイスの信頼性と寿命を大きく左右する重大な課題です。
特に、設計・開発担当者様が最も恐れるのは「市場に出てからの製品剥離によるリコール」ではないでしょうか。
近年、EVや産業機器の高効率化に伴い、SiCパワーデバイスには過酷な高温環境下での安定動作が求められており、めっき層の密着性確保がこれまで以上に重要視されています。
高温、高耐圧、大電流という過酷な環境下で動作するパワーデバイスにとって、チップと基板を繋ぐUBM(Under Bump Metal)の密着性は、製品寿命そのものを左右する生命線といえます。
しかし、従来のロジック・メモリー系と同じめっきプロセスでは、SiCデバイス特有の「厚いアルミ電極」や「広い電極面積」が災いし、アルミの局部腐食や密着不良を招くリスクが高まってしまいます。
そこで、この記事では、SiCパワーデバイスのめっきが剥がれる主な原因から、物理的・化学的なメカズム、そして信頼性を劇的に向上させるための具体的な対策技術についてご紹介いたします。
目次
1. はじめに:次世代パワー半導体に求められる「絶対的信頼性」
SiC/GaNの普及と実装技術の変遷
脱炭素社会の実現に向け、EV、再生可能エネルギー、データセンターといった分野でパワー半導体の需要が急拡大しています。
そして、これらの電力変換効率を劇的に向上させるSiC(炭化ケイ素)やGaN(窒化ガリウム)といった次世代パワー半導体の社会実装が急速に進んでいます。
こうした材料は、従来のシリコン(Si)に比べて高温動作が可能であり、高耐圧・低損失という優れた特性を持っています。
リードフレームからフリップチップ実装へのシフト
デバイスの高性能化に伴い、パッケージング技術も進化を遂げています。
従来のリードフレーム技術では、端子数やピッチの縮小、小型化・高密度化への対応が困難になりつつあります。
このため、1990年代から登場したフリップチップ実装が、現代のパワーデバイスにおいても重要な役割を担っています。
優れた放熱性と高密度実装を支える「UBM」の重要性
フリップチップ実装は、チップ裏面全体に電極を配置できるため、高密度実装が可能です。また、放熱性が高く、優れた電気特性を実現できることが大きなメリット点です。
この接続の核となるのが、電極パッド上に形成されるUBM(Under Bump Metal)です。UBMは、アルミ電極とはんだ等の接合材との仲介役となり、電気的な接続だけでなく、熱を効率よく逃がし、物理的な接合強度を維持する基盤となってくれます。
開発現場の深刻な懸念:はく離(デラミネーション)とリコールリスク
設計・開発担当者にとって最大の懸念事項は、製品の「信頼性」です。特に、過酷な環境下で使用されるパワーデバイスにおいて、市場投入後の「はく離(デラミネーション)」は、即座に致命的な故障へとつながります。
高温・大電流環境下での接合信頼性が市場競争力を決める
市場で求められるのは、熱・機械的ストレスへの高い耐性です。パワーデバイスは、動作時に激しい熱サイクルにさらされるためです。
特にSiCデバイスは300℃を超える高温域での動作も想定されるため、めっき層の密着性が不十分であれば、熱膨張差によるストレスではく離が生じます。これは即、製品寿命の終わりを意味し、大規模なリコールリスクに直結するため、極めて高い接合信頼性が求められています。
2. なぜSiCパワーデバイスのめっきは剥がれるのか?(メカニズム解析)
ロジック系とは決定的に異なる「パワーデバイス用UBM」の要求仕様
一般的なロジックICやメモリーと、パワーデバイスとでは、めっきプロセスにおける条件が大きく異なります。
アルミ電極の厚膜化(数$\mu m$単位)への対応
ロジック系ではサブミクロンレベルの薄膜電極が一般的ですが、パワーデバイスのアルミ電極は、大電流を流すために数$\mu m$(例えば$3\sim5\mu m$)と非常に厚く設計されています。
この厚いアルミ層に対して、いかにダメージを与えず均一にめっきを施すかが課題となります。
めっき面積率の大幅な増大(50%以上)による浴負荷の影響
また、パワーデバイスはウェハ上のめっき面積率が非常に高いのが特徴です。ロジック系が数%から10%程度であるのに対し、パワーデバイスでは50%を超えることも珍しくありません。
これにより、めっき反応時に発生する副生成物や、アルミの溶解量が増大し、めっき浴への負荷が激増することで、皮膜の品質管理が困難になります。
はく離の主因:アルミニウム電極の局部腐食(ピット)
めっき剥離の根本原因の多くは、前処理工程である「ジンケート処理(亜鉛置換)」に潜んでいます。
ジンケート処理(亜鉛置換)時に発生する深い腐食孔のリスク
アルミ電極上に無電解ニッケルめっきを施す際、密着性を確保するためにアルミを亜鉛に置き換えるジンケート処理が必要です。しかし、パワーデバイス特有の厚いアルミ層や大きな面積率の影響で、置換反応が不均一になりやすく、アルミを深く掘り下げてしまう「局部腐食(ピット)」が発生しやすくなります。
腐食によって密着性が不均一になり、熱サイクルによるはく離を誘発
ピットが形成されると、その後のニッケルめっきが不均一に成長し、界面に脆弱な構造が形成されます。その結果、見かけ上の初期密着力は確保できているように見えても、熱サイクル試験時などのストレスに耐え切れず、接合部のクラックや剥離が発生するのです。
3. 「証拠データ」で見る:信頼性を損なう2つの技術的落とし穴
落とし穴①:ジンケート処理における不均一なZn皮膜
ジンケート処理によって形成される亜鉛(Zn)皮膜が粗大であったり、不均一であったりすると、その上のニッケル層との間に微細な隙間や欠陥が生じます。
腐食ピットにめっきが潜り込み、見かけ上の密着は保たれても、応力集中により破綻するメカニズム
アルミが深く浸食されたピット内にめっきが入り込むと、アンカー効果によって一時的に強度は出ますが、アルミ自体が「スカスカ」の状態になっているため、金属としての構造強度が著しく低下しています。一見、アンカー効果で密着しているように見えますが、過酷な環境下では、この脆弱なアルミ層自体が破壊される「素材破壊」に近い形ではく離が進行します。
落とし穴②:金めっき厚膜化に伴う下地ニッケルの溶解
パワーデバイスでは、酸化防止や、はんだ濡れ性を確保するために施される「置換金(Au)めっき」にも大きなリスクが存在します。
従来の置換型金めっきでは、厚膜化の過程でニッケル層が局部腐食を起こす
一般的な置換金めっきは、下地のニッケルを溶かしながら金が析出する反応です。金を厚く付けようとすると(厚金化)、その分だけ下地のニッケルが激しく浸食され、界面に「ブラックパッド」と呼ばれる腐食層や空隙(カーケンダルボイド)が形成されます。
脆弱な金属間化合物(IMC)の異常成長と信頼性の低下
ニッケル層が腐食された状態で、はんだ接合を行うと、脆い金属間化合物(IMC)が異常成長しやすくなります。これが、衝撃や熱膨張に対して極めて脆い接合部となってしまい、パワーデバイスに不可欠な長期信頼性を損なう第二の要因となります。
4. 解決策:メルテックスが提案する「局部腐食ゼロ」のUBMプロセス
メルテックスでは、これらの課題を解決するために、アルミへのダメージを最小限に抑えつつ最強の密着性を実現するUBMプロセスを開発しました。
【特許技術】緻密なジンケート膜によるアルミ電極の保護
メルテックスのジンケート処理技術は、独自の添加剤処方により、アルミの過剰な溶解を抑制しつつ、極めて緻密で均一な亜鉛皮膜を形成します。
ジンケートの最適化により、腐食を抑制し平滑な皮膜を形成
この技術を用いると、断面観察においてアルミ電極の浸食がほとんど見られない「平滑な界面」を維持できます。腐食ピットをゼロに近づけることで、ニッケル層との密着を原子レベルで安定させ、応力集中を防ぐことが可能となります。
【次世代技術】置換還元金めっきによる厚金化と高信頼性の両立
金めっき工程では、下地ニッケルを保護しながら厚膜化が可能な「置換還元型金めっき」を提案しています。
ニッケルの溶解を抑えつつ、$0.1 \sim 0.5 \mu m$の厚金形成を実現
このプロセスは、置換反応と還元反応をバランスよく進行させることで、下地ニッケルの腐食を極限まで抑えながら、$0.1 \mu m$から$0.5 \mu m$といった厚い金皮膜を形成できます。
はんだ濡れ性とバリア層保護の究極のバランス
ニッケル層が健全に保たれるため、はんだ接合後の接合強度が安定し、パワーサイクル試験においても優れた耐性を示します。まさに、はんだ濡れ性の向上とバリア層(ニッケル)の保護を両立した、パワーデバイスに最適なソリューションだといえます。
5. 解析データによるスペックインの裏付け
断面SEM写真による比較データ
理論だけでなく、実際の解析データが当社の優位性を証明しています。
従来プロセス vs 改良プロセスのアルミ表面状態の明らかな差
SEM(走査型電子顕微鏡)による断面観察では、従来プロセスで見られた鋭い腐食ピットが、メルテックスの改良プロセスでは消失していることが明確に確認されています。この界面の「美しさ」こそが、信頼性の源泉なのです。
過酷な熱ストレス試験後の接合強度データが示す優位性
当社のUBMは、緻密なUBM層を形成することで、熱・機械的ストレスに対する耐性が向上し、$-40^\circ\text{C}$から$+150^\circ\text{C}$(あるいはそれ以上)の冷熱サイクル試験後においても、初期の接合強度を高い水準で維持できます。
パワーデバイス特有の「反り」と「熱膨張」を制御する低応力設計
大口径ウェハの反りは歩留まりに直結します。ウェハの薄化が進む中で問題となる「反り」に対しても、めっき膜自体の内部応力を低減する設計がなされています。これにより、プロセス中のウェハ破損を防ぎ、歩留まり向上に貢献します。
6. まとめ:確かな表面処理技術がSiCの未来を支える
信頼性の高いUBMプロセスの選定がスペックインの鍵
パワー半導体の需要拡大に伴い、技術要求は高度化し続けています。SiCパワーデバイスの性能を最大限に引き出し、過酷な市場環境で勝ち残るためには、単に「付着している」だけのめっきではなく、界面の局部腐食をコントロールし、熱ストレスを計算に入れた「高信頼性UBM」の選定が不可欠です。
メルテックスの知見:HDD用アルミディスクから培われた高度な表面処理技術の応用
当社は、1980年代後半からハードディスク(HDD)用Al円盤への無電解ニッケルめっきにおける主要サプライヤーとして実績を積んできました。世界中でシェアを持つHDD用下地めっきで培った「極限の平滑性と密着性」を実現する知見を、現在のパワーデバイス向けプロセスにも惜しみなく投入しています。
結び:開発のパートナーとしてのメルテックス
次世代パワー半導体の開発において、アルミ電極の腐食や、めっきの剥離、厚金化の課題にお悩みの方は、ぜひメルテックスにご相談ください。貴社の製品が次世代社会のインフラを支える「絶対的な信頼性」を確保できるよう、全力でサポートいたします。
製品の仕様詳細や、貴社の排出量に基づいたコスト削減シミュレーションのご依頼は、下記よりお気軽にお問い合わせください。

