功率半导体的无电解电镀镍药水
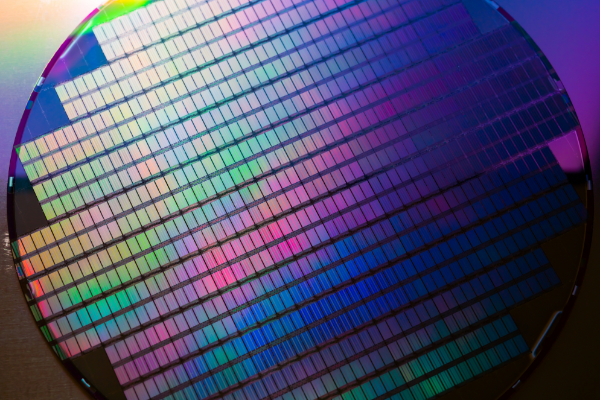
功率半导体UBM所需的特性
当通过凸点将半导体芯片连接到封装基板时,UBM(Under Bump Metal 或 Under Barrier Metal 的缩写) 会在芯片上的铝电极与焊料之间形成,作为阻挡层以抑制相互扩散。 为了在焊接过程中确保阻挡性能和表面保护,UBM 通常采用镍/金或镍/钯/金的结构。 近年来,功率半导体趋向于更高电压和更大电流,其工作温度也不断升高,因此对镀层提出了更高的耐热性要求。 传统的化学镀镍膜在高温下有时会出现裂纹,因此需要改进。 此外,与逻辑半导体相比,功率半导体的电极尺寸更大,因此更适合使用针对功率半导体优化的化学镀镍液,以获得优良的镀层质量。
Melplate NI-869A 的特点
我们开发了一种适用于功率半导体并具有高耐热性的化学镀镍液——Melplate NI-869A。
Melplate NI-869A 具有以下特点
- ・优异的抗裂性能:在 360°C 热处理 3 分钟后无裂纹产生
- ・镀层厚度面内变化极小
- ・焊接界面处的镍层减少量极小
高耐热性,确保高连接可靠性
在 360°C 热处理 3 分钟 后,传统化学镀镍液中的镀层会产生裂纹,导致连接可靠性无法保证。 而 Melplate NI-869A 镀层即使经过热处理也不会出现裂纹。 传统的化学镀镍液在镀覆后形成的是非晶结构,但在热处理过程中会发生再结晶等结构变化。 然而,Melplate NI-869A 镀层在热处理后晶体结构几乎没有变化,因此即使经过热处理也能有效抑制裂纹的产生。

实现高镀层厚度均匀性
除了具有优异的耐热性外,Melplate NI-869A 在晶圆表面也展现出出色的镀层厚度均匀性。 通常,化学镀镍的沉积速率会受到搅拌的影响,搅拌强度的变化会导致镀层厚度的不均匀。 为了实现均匀的镀层厚度,不仅需要改进镀液本身,还需要优化设备设计。 Melplate NI-869A 通过其镀液特性,最大限度地降低了搅拌对镀速的影响,从而显著减少了面内厚度的变化。
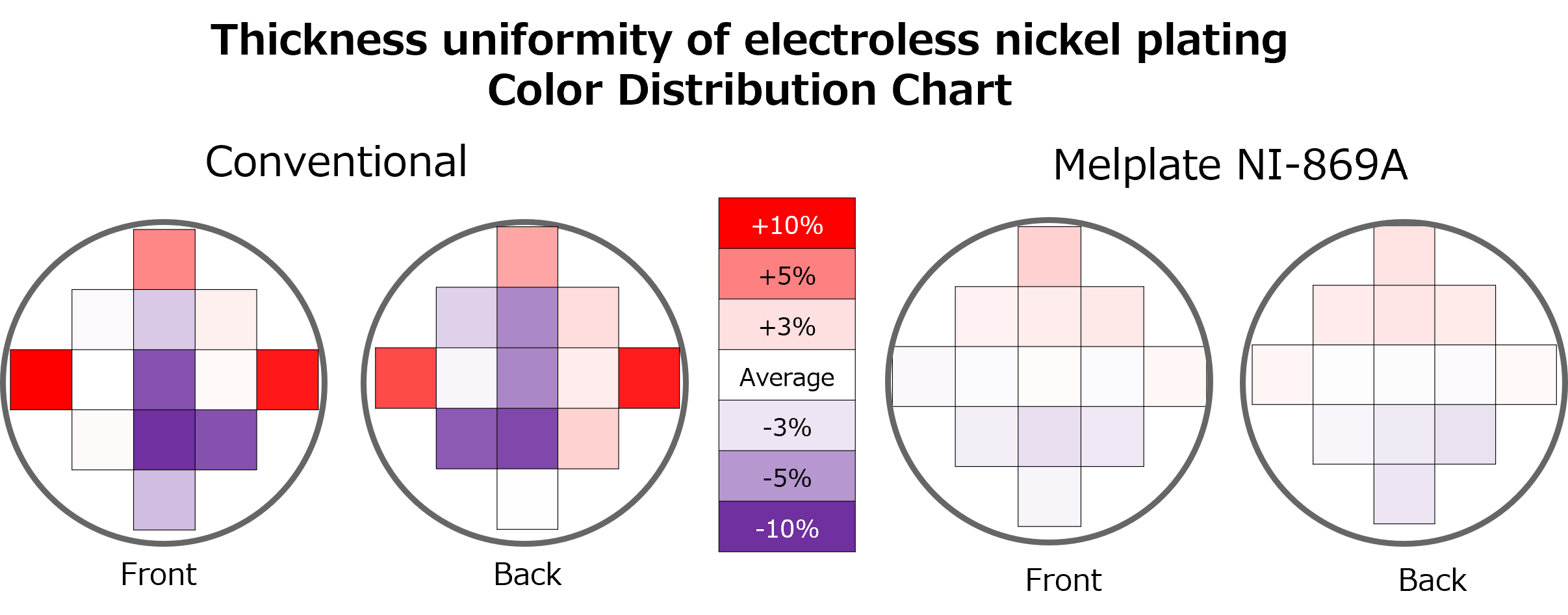
确保连接可靠性的化学镀镍液
Melplate NI-869A 是一款专为功率半导体优化的化学镀镍液,具有高耐热性和用于 UBM 形成的高镀层厚度均匀性。我们的 Melplate UBM 工艺可作为前处理使用。(→Reference link)Melplate UBM 工艺可用于对各种铝合金电极进行化学镀镍前处理,几乎不会造成损伤。
联系我们
如需了解更详细的性能数据、应用信息、试作支持或其他相关事项,欢迎随时与我们联系。
我们将首先通过电子邮件回复您。

