無電解UBM形成プロセス
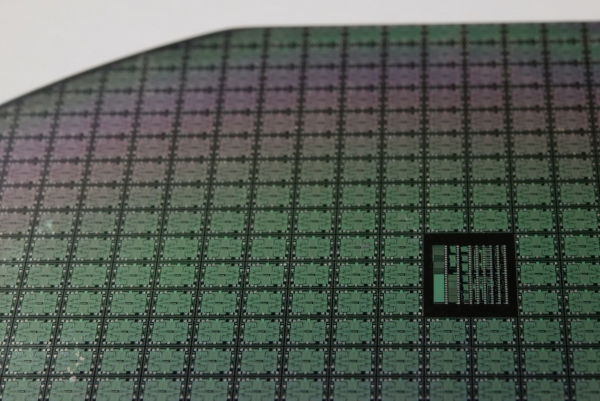
UBM形成技術
UBMは、Under Bump MetalもしくはUnder Barrier Metalの略称で、半導体チップ上の金属パッドとはんだ、もしくはワイヤボンディングでの接合において、接合信頼性を確保するために形成される被膜です。バリア性および接合時の表面保護の観点から、ニッケル/金やニッケル/パラジウム/金などの構成で形成されます。
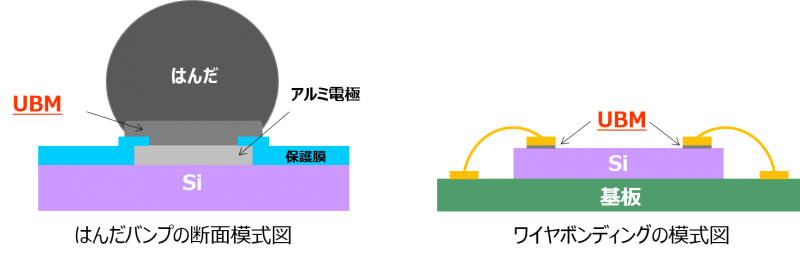
メルプレートUBMプロセス
メルプレートUBMプロセスは、無電解めっきによりUBMを形成するプロセスです。電解によるバンプ形成プロセスに比較して、露光現像工程が不要で、短い工程でUBMを形成できます。
また、メルプレートUBMプロセスは、前処理に特許技術を含み、“様々なアルミ電極の種類に対応”し、“電極へのダメージを最小限にし、かつ平滑性に優れた被膜”を形成できるプロセスです。ご要望に合わせ、Ni/Au被膜もしくはNi/Pd/Au被膜を形成するめっき液をご準備しております。 
無電解Niめっき メルプレートNI-869
メルプレート NI-869はUBM向け無電解ニッケルめっき液です。
- ・析出速度:12~17 μm/hr
- ・リン含有率:6~8 wt%
- ・アルカリ金属、ハロゲン、Pbフリー
- ・開口径10 μmの微小電極上へも良好な被膜を形成
- ・Pbフリーはんだに対する優れたバリア性を発揮
置換Auめっき メルプレートAU-7621
メルプレート AU-7621はUBM向け置換金めっき液です。
- ・シアンフリー(亜硫酸タイプ)
- ・析出速度:0.05 μm/20分
- ・良好な浴安定性および簡易な浴管理
- ・均一なAuめっき被膜の形成および良好なはんだ接合性
- ・従来浴と比較し、Niめっき膜の局部腐食を抑制
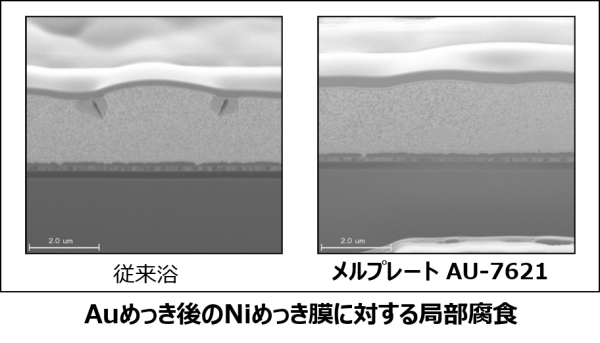
無電解Pdめっき メルプレートPal-6500
メルプレート Pal-6500はUBM向け無電解パラジウムめっき液です。
- ・還元型無電解純パラジウムめっき薬品
- ・優れた浴安定性および選択析出性
- ・下地ニッケル皮膜の表面への拡散に対する良好なバリア性
- ・良好なボンディング特性
Ni/Pd/Au被膜構成の効果
① バリア性
メルプレートUBMプロセスの無電解ニッケルめっきメルプレートNI-869は他浴と比較して高いバリア性を発揮します。Ni/Pd/Auの構成にすることで、さらに膜減りを抑制します。 
② ボンディング性
リフロー後、Ni/Auでは、Au表面にNiめっきが拡散し、ワイヤボンディング性が低下することがあります。一方、Ni/Pd/Auの構成では、Niの表面への拡散が抑制され、安定したワイヤボンディング性を実現します。 
メルプレートUBMプロセスの特長
メルプレートUBMプロセスは、Al電極上に無電解ニッケル金、無電解ニッケルパラジウム金めっきを被膜を形成するためのプロセスです。メルプレートUBMプロセスの前処理プロセスは、以下の特長を持ちます。 
お問い合わせ
より詳しい特性データのご要望、用途・試作についてのご相談など、お気軽にお申しつけください。
まずはメールにてご返答させていただきます。

