Melplate UBM 预处理工艺

UBM形成技术
在倒装芯片(Flip Chip)方法中,半导体芯片通过凸点与基板连接。UBM(凸点下金属)形成于芯片上的铝电极与焊料之间的界面,作为限制元素互扩散的阻挡层。UBM 是“Under Bump Metal”或“Under Barrier Metal”的缩写,通常由镍/金、镍、钯/金等材料组成。形成 UBM 是为了确保阻挡性能并保护焊点处的表面。
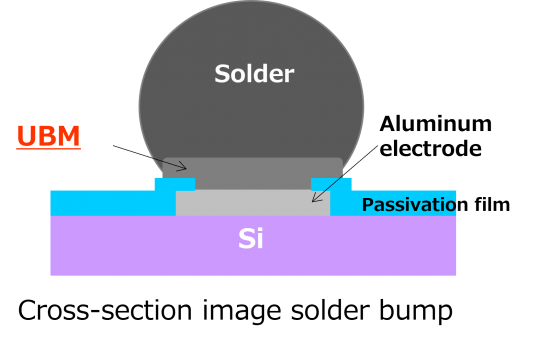
使用化学镀形成 UBM
为了通过电镀形成 UBM,可以采用电解镀和化学镀两种方法。Meltex 提供的 Melplate UBM 工艺是利用化学镀来形成 UBM 的。
化学镀可以选择性地在金属电极上形成镀膜。因此,形成凸点时无需曝光和显影工艺,也无需使用光刻胶即可完成膜层的形成。化学镀的另一个优点是 UBM 和焊锡凸点的高度更加稳定。
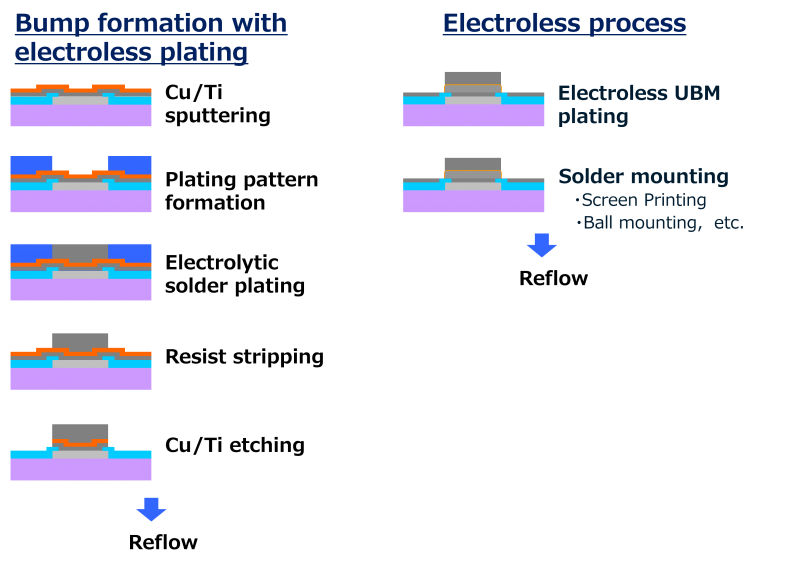
Melplate UBM 工艺中的优异前处理
Melplate UBM 工艺中的前处理是一种优化各个处理步骤的工艺,包含专利技术,能够应对多种类型的铝电极,并在最大程度上减少对电极的损伤,从而形成极为平滑的 UBM。
在经过前处理工艺后,化学镀可形成 Ni/Pd、Ni/Pd/Au 或其他类型的 UBM。
与铝电极类型无关的前处理(专利技术)
铝电极除了纯铝外,还可以由铝铜(Al-Cu)、铝硅铜(Al-Si-Cu)、铝硅(Al-Si)等铝合金制成。根据铝合金的类型不同,锌置换处理可能会出现不均匀现象,从而导致镀层外观缺陷。
Melplate UBM 工艺中的前处理采用了专利的蚀刻与调理处理技术,实现了与铝电极类型无关的前处理,使后续的锌置换处理更加均匀。此外,该工艺还可应对因电极在设计中存在电位差或晶向差异而导致的镀层厚度不一致或沉积失败的问题。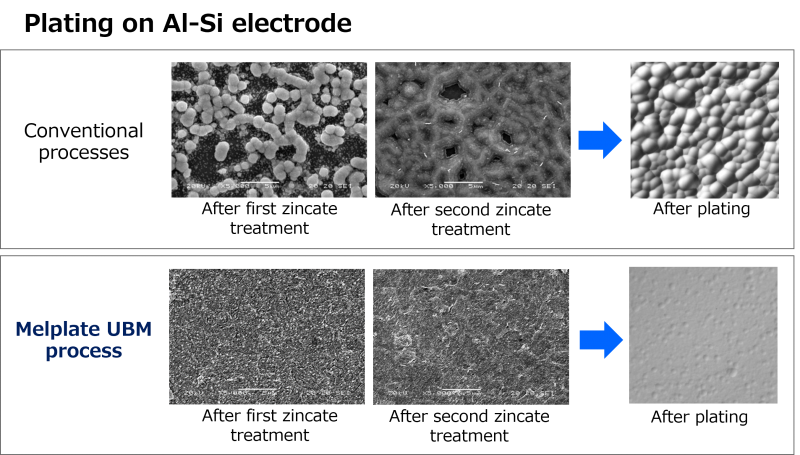
通过锌置换处理减少镍尖晶的产生
为了在铝电极上进行化学镀,必须进行称为锌置换处理的锌替代处理。虽然第一步和第二步锌置换处理通常使用相同的药液,但在 Melplate UBM 工艺中,明确区分了两步处理的目的,并分别配制了针对各自用途的专用药液。
第一步锌置换处理经过优化,可消除铝电极上的局部腐蚀;而第二步锌置换处理则经过优化,以实现镀层的高附着力。该处理方式不仅最大限度地减少了电镀后的镍尖晶现象,还实现了镀层的优异附着性能。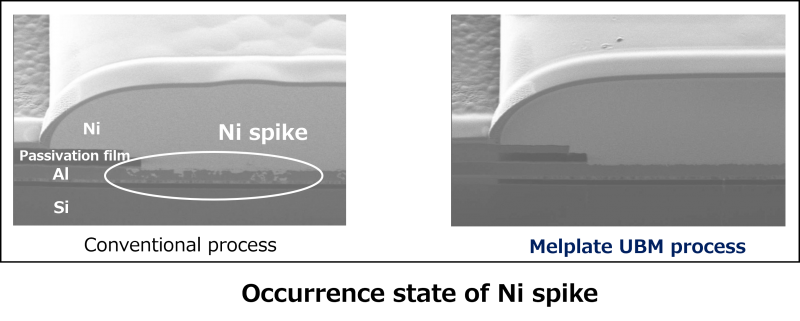
Melplate UBM 工艺的特点
Melplate UBM 工艺旨在在铝电极上形成化学镀镍金或化学镀镍钯金的镀层。该工艺中的前处理过程具有以下特点:
- ・对铝合金电极几乎无损伤
- ・不受铝合金类型限制
- ・几乎不受电极电位影响
这些特点使得在铝与化学镀镍的界面上形成的化学镀膜具有优异的附着力,表面平滑,并且无镍尖晶现象。
联系方式
如需了解更详细的性能数据、应用案例、试作支持或其他相关事项,欢迎随时与我们联系。
我们将首先通过电子邮件回复您。

