化学镀 UBM 形成工艺
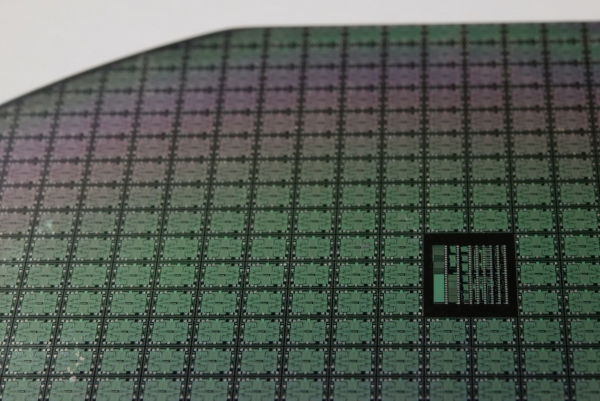
UBM形成技术
UBM 是 Under Bump Metal(凸点下金属)或 Under Barrier Metal(下阻挡金属)的缩写。它是一种用于确保半导体芯片金属焊盘与焊料或金线之间连接可靠性的金属膜。从阻挡性能和键合过程中的表面保护角度来看,UBM 通常由镍/金或镍/钯/金等结构组成。
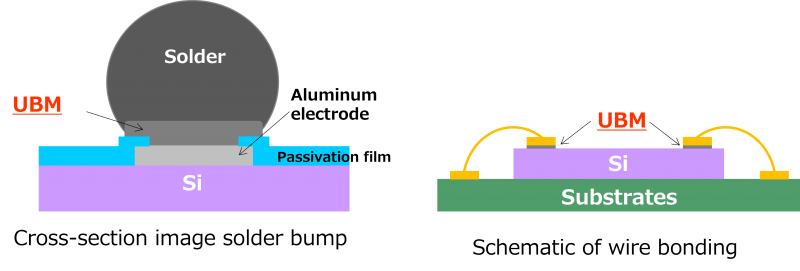
Melplate UBM 工艺
Meltplate UBM 工艺是一种通过化学镀方式形成 UBM(下金属层)的工艺。与电解凸点形成工艺相比,Meltplate UBM 工艺无需曝光和显影步骤,能够在较短时间内完成 UBM 的形成。 此外,Meltplate UBM 工艺在前处理过程中采用了专利技术,可适用于多种类型的铝电极,最大限度地减少对电极的损伤,并形成平滑的金属膜。我们可根据您的需求,提供用于形成 Ni/Au 或 Ni/Pd/Au 膜层的镀液解决方案。 
化学镀镍 Melplate NI-869
Melplate NI-869 是一种用于 UBM 的化学镀镍溶液。
- ・沉积速率:12 至 17 微米/小时
- ・磷含量:6 至 8 重量百分比(wt%)
- ・本产品不含碱金属、卤素元素及铅,符合环保要求
- ・即使在直径为 10 微米的微电极上也能形成优异的镀膜
- ・对无铅焊料具有优异的阻挡性能
替代性金镀液 Melplate AU-7621
Melplate AU-7621 是一种用于 UBM 的替代性金镀液。
- ・无氰(亚硫酸型)
- ・沉积速度:0.05 微米/20 分钟
- ・镀液稳定性好,易于管理和控制
- ・镀金膜均匀,焊接性良好
- ・与传统镀液相比,可抑制镀镍膜的局部腐蚀
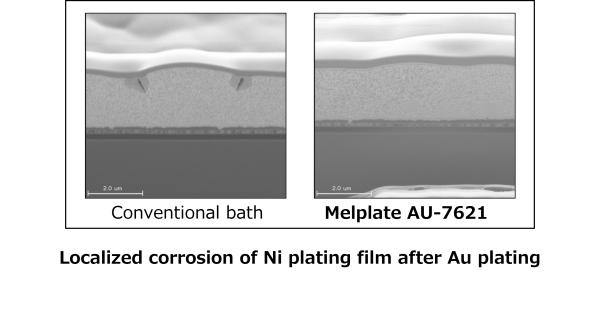
化学镀钯 Melplate Pal-6500
Melplate Pal-6500 是一种用于 UBM 的化学镀钯溶液。
- ・还原型化学镀纯钯溶液
- ・浴液稳定性优异,具有选择性沉积性能
- ・对底层镍镀层向表面扩散具有优异的阻隔性能
- ・良好的结合性能
Ni/Pd/Au 薄膜组成的影响
① 阻隔性能
Melplate UBM 工艺中的化学镀镍液 Melplate NI-869 具有比其他镀液更高的阻隔性能,Ni/Pd/Au 的膜层结构进一步抑制了膜层的损耗。 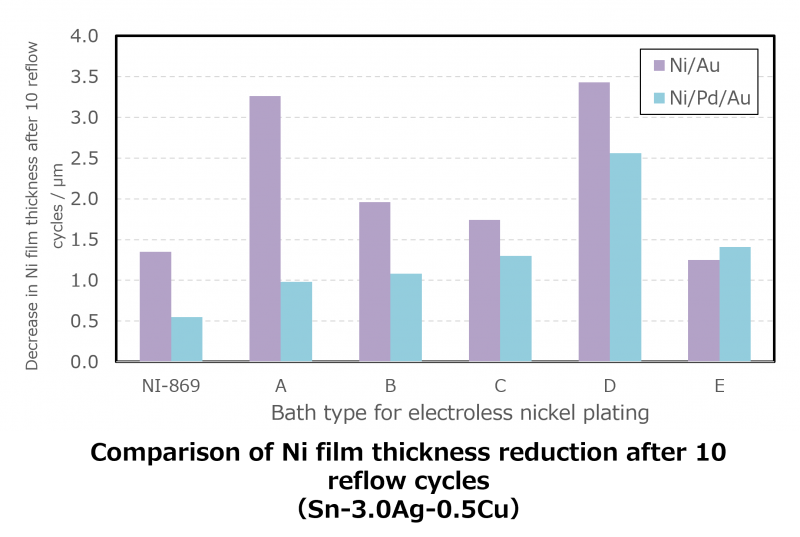
② 结合
在 Ni/Au 结构中,回流焊后镍镀层会向金表面扩散,可能导致金线键合性能下降。而在 Ni/Pd/Au 结构中,镍向表面的扩散受到抑制,从而实现了稳定的金线键合性能。 
Melplate UBM 工艺的特点
Melplate UBM 工艺是一种在铝电极上形成化学镀镍金或化学镀镍钯金膜层的工艺。该工艺的前处理过程具有以下特点。 
联系方式
如需了解更详细的特性数据、应用信息、试作支持或其他相关事项,欢迎随时与我们联系。
我们将首先通过电子邮件回复您。

